Une équipe de recherche conjointe de l’Université des sciences et technologies d’Ulsan et de l’Université des sciences et technologies de Pohang, dirigée par les professeurs Byungjo Kim et Jihwan An, a développé avec succès un nouveau procédé de dopage plasma postérieur (PDP), améliorant significativement les performances des dispositifs de mémoire DRAM. Avec la miniaturisation croissante des équipements électroniques, les semi-conducteurs de mémoire comme la DRAM font face à des problèmes de fuites et de réduction de stabilité, rendant les techniques de fabrication traditionnelles insuffisantes.
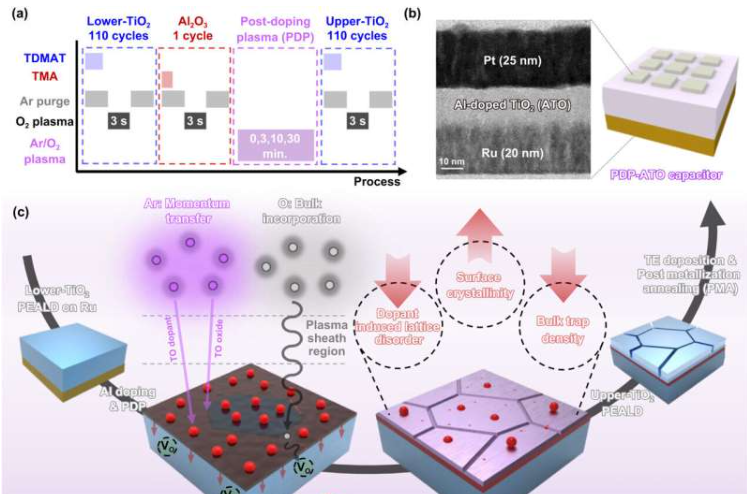
Le condensateur dans la DRAM est un élément clé pour stocker les charges, sa performance dépendant largement de la qualité de la couche diélectrique. Le dioxyde de titane dopé à l’aluminium (ATO) est un matériau diélectrique idéal en raison de sa constante diélectrique élevée et de ses excellentes propriétés de suppression des courants de fuite. Cependant, l’ATO préparé par la méthode traditionnelle de dépôt en couche atomique (ALD) présente des problèmes de désordre de réseau et de vacances d’oxygène, entraînant une instabilité du matériau et une augmentation des courants de fuite. Pour résoudre ce défi, l’équipe de recherche a introduit le procédé PDP, qui consiste, après le dépôt de la couche diélectrique TiO₂ par ALD, à appliquer une couche ultra-mince d’oxyde d’aluminium, puis à traiter avec un plasma composé d’argon et d’oxygène. Le traitement plasma favorise non seulement la migration atomique du dopant aluminium et la réorganisation du réseau, mais remplit également efficacement les vacances d’oxygène, améliorant ainsi considérablement les performances des condensateurs DRAM. Les données expérimentales montrent que la constante diélectrique des condensateurs DRAM traités par PDP a augmenté d’environ 30 %, et le courant de fuite a diminué de près de 40 fois.
